-
NPE-4000 (M) 等离子体化学气相沉积系统

等离子诱导表面改性:就是通常所说的用等离子实现表面改性(如亲水性、疏水性等)等离子清洗:去除有机污染物等离子聚合:对材料表面产生聚合反应沉积二氧化硅、氮化硅、DLC(类金刚石),以及其它薄膜
-
NSC-3000 (M) 磁控溅射系统
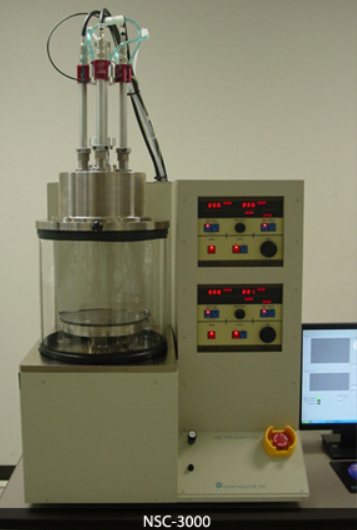
不锈钢腔体RF、DC溅射RF或DC偏压(1000V)样品台可加热到700°C膜厚监测仪基片的RF射频等离子清洗预真空锁以及自动晶圆片上/下载片 NSC-3000(M)磁控溅射系统带有水冷或者
-
NLD-3500 (A) 全自动原子层沉积系统

NLD-3500(A)全自动原子层沉积系统特点:NLD-3500(A)是一款全自动独立的PC计算机控制的ALD原子层沉积系统,带Labview软件,具备四级密码控制的用户授权保护功能。系统为
-
NIE-4000 (A) 全自动IBE离子束刻蚀
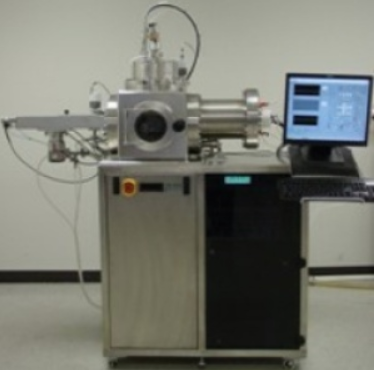
14.5”不锈钢立体离子束腔体16cm DC离子枪1200eV,650mA, 气动不锈钢遮板6”水冷样品台晶片旋转速度3、10RPM,真空步进电机典型刻蚀速率:铜200 ?/min, 硅:500
-
LSC-4000 (D) 兆声大基片湿法去胶系统

LSC-4000 (D) 兆声大基片湿法去胶系统概述:zei新技术的兆声和清洗技术的发展,对MEMS和半导体等领域的晶圆和掩模版清洗提供了zei新的水平,可以帮助用户获得zei干净的晶圆片和掩模
-
高温等离子样品台
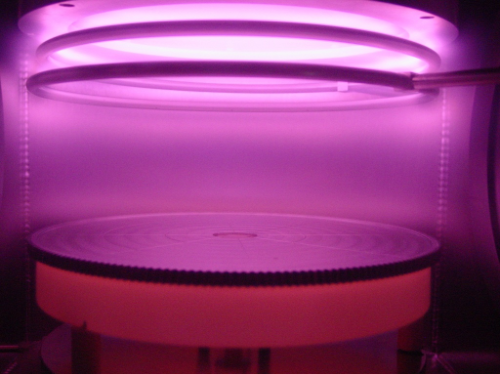
NM-LTP:低温样品台,可加热到3000CNM-MTP:中温样品台,可加热到5000CNM-HTP:高温样品台。可加热到7000C NANO-MASTER(那诺-马斯特)样品台可以直接安装
-
NIE-4000 (R) RIBE反应离子束刻蚀
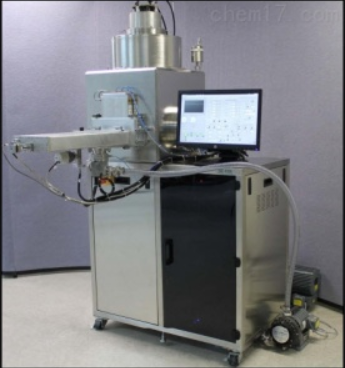
14.5”不锈钢立体离子束腔体16cm DC离子枪1200eV,650mA, 气动不锈钢遮板6”水冷样品台晶片旋转速度3、10RPM,真空步进电机典型刻蚀速率:铜200 ?/min, 硅:500
-
NSC-3000 (A) 全自动磁控溅射系统

不锈钢腔体RF、DC溅射RF或DC偏压(1000V)样品台可加热到700°C膜厚监测仪基片的RF射频等离子清洗 NSC-3000(A)全自动磁控溅射系统概述:带有水冷或者加热(最高可加热到
-
NTE-3000 热蒸镀系统

NTE-3000蒸发系统是一个台式系统,跟我们的溅射系统共享一个共同的平台;比如:橱柜,腔体,真空系统,计算机控制架构等方面都是一样的。唯一的区别是一个使用磁控管,另一个使用加热坩埚. 因此,在
-
NDR-4000 (A) 全自动DRIE深反应离子刻蚀

外观尺寸:紧凑型立柜式设计,不锈钢腔体,外观尺寸为28”(W) x 42”(L) x64”(H);等离子源:NM ICP平面等离子源,带淋浴头气体分布系统。等离子源安装在腔体顶部,通过
想在此推广您的产品吗?
咨询热线: 010-84839035
联系邮箱: sales@antpedia.net